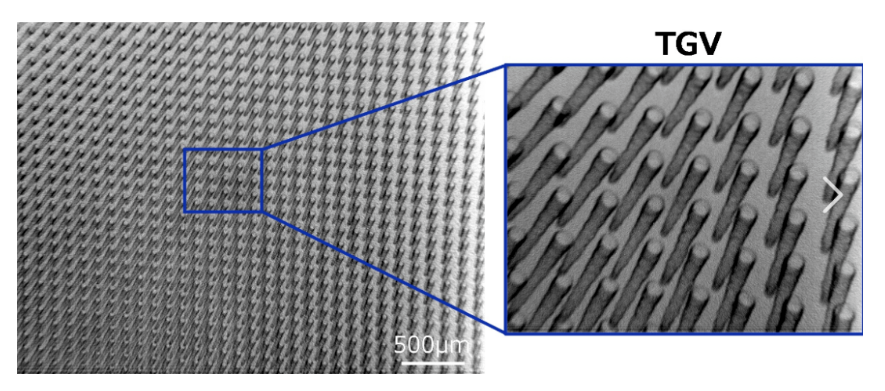
Ce este TGV-ul?
TGV (trecere prin sticlă), o tehnologie de creare a găurilor străpunse pe un substrat de sticlă. În termeni simpli, TGV este o clădire înaltă care perforează, umple și conectează sticla în sus și în jos pentru a construi circuite integrate pe podeaua de sticlă. Această tehnologie este considerată o tehnologie cheie pentru următoarea generație de ambalaje 3D.

Care sunt caracteristicile TGV-ului?
1. Structură: TGV este o gaură conductivă traversantă, care pătrunde vertical, realizată pe un substrat de sticlă. Prin depunerea unui strat metalic conductiv pe peretele porului, straturile superior și inferior ale semnalelor electrice sunt interconectate.
2. Procesul de fabricație: Fabricația TGV include pretratarea substratului, realizarea găurilor, depunerea stratului metalic, umplerea găurilor și etapele de aplatizare. Metodele comune de fabricație sunt gravarea chimică, găurirea cu laser, galvanizarea și așa mai departe.
3. Avantajele aplicației: Comparativ cu orificiile metalice tradiționale, TGV are avantajele unor dimensiuni mai mici, o densitate mai mare a cablajului, o performanță mai bună de disipare a căldurii și așa mai departe. Este utilizat pe scară largă în microelectronică, optoelectronică, MEMS și alte domenii de interconectare de înaltă densitate.
4. Tendință de dezvoltare: Odată cu dezvoltarea produselor electronice către miniaturizare și integrare ridicată, tehnologia TGV se bucură de tot mai multă atenție și aplicații. În viitor, procesul său de fabricație va continua să fie optimizat, iar dimensiunea și performanța sa vor continua să se îmbunătățească.
Ce este procesul TGV:
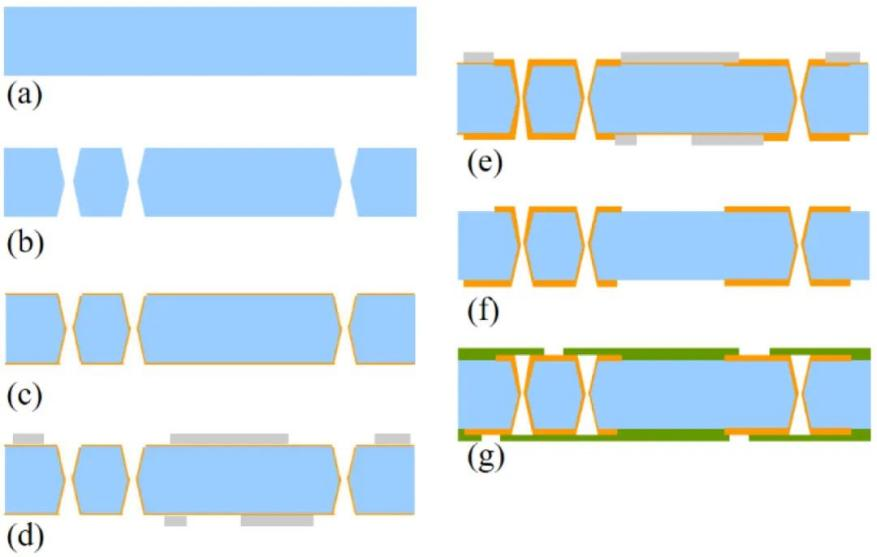
1. Pregătirea substratului de sticlă (a): Pregătiți un substrat de sticlă la început pentru a vă asigura că suprafața acestuia este netedă și curată.
2. Găurirea sticlei (b): Un laser este utilizat pentru a forma o gaură de penetrare în substratul de sticlă. Forma găurii este în general conică, iar după tratamentul cu laser pe o parte, aceasta este întoarsă și prelucrată pe cealaltă parte.
3. Metalizarea peretelui găurii (c): Metalizarea se efectuează pe peretele găurii, de obicei prin PVD, CVD și alte procese pentru a forma un strat de semințe metalice conductive pe peretele găurii, cum ar fi Ti/Cu, Cr/Cu etc.
4. Litografie (d): Suprafața substratului de sticlă este acoperită cu fotorezist și fotomodelată. Se expun părțile care nu necesită placare, astfel încât doar părțile care necesită placare să fie expuse.
5. Umplerea găurilor (e): Galvanizarea cu cupru pentru a umple sticla prin găuri și a forma o cale conductivă completă. În general, este necesar ca gaura să fie complet umplută, fără găuri. Rețineți că Cu-ul din diagramă nu este complet populat.
6. Suprafața plană a substratului (f): Unele procese TGV vor aplatiza suprafața substratului de sticlă umplut pentru a asigura o suprafață netedă a substratului, ceea ce este propice etapelor ulterioare ale procesului.
7. Strat protector și conexiune terminală (g): Pe suprafața substratului de sticlă se formează un strat protector (cum ar fi poliimidă).
Pe scurt, fiecare etapă a procesului TGV este critică și necesită control și optimizare precise. În prezent, oferim tehnologia TGV pentru găuri de sticlă, dacă este necesar. Vă rugăm să ne contactați!
(Informațiile de mai sus provin de pe internet, cenzurate)
Data publicării: 25 iunie 2024
